TSV,硅通孔技术是英文Through-Silicon Via的缩写,即是穿过硅基板的垂直电互连,可以穿过硅基板实现硅片内部垂直电互联,这项技术是目前唯一的垂直电互联技术,是实现3D先进封装的关键技术之一。TSV技术能够将晶圆与晶圆之间垂直导通、芯片与芯片之间垂直导通,从而实现晶圆堆叠、芯片堆叠,其目的在于大幅提升芯片性能,是解决摩尔定律失效的重要技术之一。
21世纪初,TSV被提出。在TSV技术问世之前,芯片之间水平互联,为提高性能,芯片数量增加,会占据基板更多空间。TSV技术可以使多个芯片垂直堆叠,在提高性能的同时,大幅降低了芯片占用的基板空间。由于TSV技术的核心技术例如深硅刻蚀、铜电镀等技术逐步发展成熟,这是由于技术的突破HBM高宽带迎来了高光时刻,TSV技术商业化发展也开始快速向前。
为提高计算能力与存储能力,芯片工艺制程不断缩小,目前,5nm芯片已经量产,3nm芯片即将量产,芯片性能开发已接近物理极限,摩尔定律失效。全球互联网用户规模不断增长,人工智能、物联网等产业快速发展,使得数据产生量急剧增多,市场对芯片的性能要求还在不断提高。摩尔定律失效与芯片性能要求继续提高之间相互冲突,需要采用新的技术手段来解决,因此TSV技术快速成为新一代封装技术。
根据新思界产业研究中心发布的《2022-2027年中国TSV(硅通孔)行业市场深度调研及发展前景预测报告》显示,TSV技术具有高密度集成、多功能集成、缩短电传输路径、减少信号延迟、增加带宽、提高数据传输速率、降低功耗等优点,几乎可以用于任何芯片封装以及任何类型先进封装领域,受到了多个半导体厂商的关注。在全球范围内,TSV技术相关厂商主要有日本东芝、韩国SK海力士、瑞士意法半导体、瑞士Silex公司、美国英特尔、美国AMD、美国应用材料公司等。
TSV技术应用规模逐步扩大,2022年3月,苹果公司推出M1 ULTRA处理器,即采用TSV技术进行集成。我国是全球最大的电子产品生产国,随着技术进步,电子产品更新迭代速度加快,市场对高性能芯片需求日益旺盛。在此背景下,我国TSV市场拥有巨大发展空间。我国目前已经拥有TSV技术相关企业,例如大港股份控股下属公司苏州科阳主要采用TSV技术提供晶圆级封装服务。
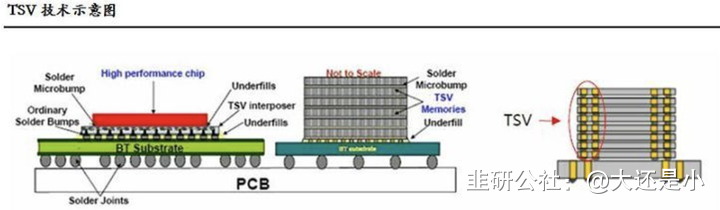
通过在芯片和芯片之间、晶圆和晶圆之间制作垂直导通;TSV技术通过铜、钨、多晶硅等导电物质的填充,实现硅通孔的垂直电气互连,实现芯片之间互连的最新技术。
TSV实质上并不能说是一种封装技术方案,它只是一种先进封装工艺中的重要一环。
由于TSV的诞生,半导体裸片和晶圆可以实现以较高的密度互连堆叠在一起,这也成为了先进封装技术的标志之一。
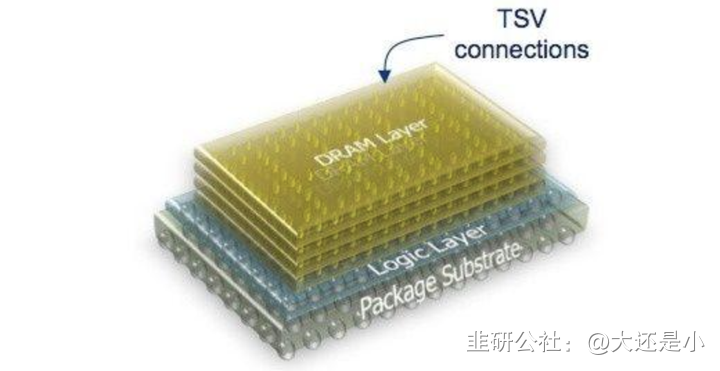
1.在此之前,芯片之间的大多数连接都是水平的。这意味着板上芯片与芯片之间将散布在板上,整体的占用空间将随着具体功能的叠加而指数性增大。
2,TSV的诞生使得垂直堆叠多个芯片成为了可能。这将大幅度减少了它们占用的面积,因为它们不会散布在板上。
这也意味着,使用了TSV技术的先进封装将有以下优势:高密度集成、提高电性能、多种功能集成、降低制造成本.
TSV在CIS{图像传感器}和HBM中的大规模应用,TSV技术的发展创新空间有了制约。无论是 CIS 还是 HBM,其中用到的 TSV 都是孔径只有 10 微米左右的小孔径 TSV, 而基于电镀的 TSV 却一直没能攻下最后一个阵地:大孔径 TSV 的实心填充。对于大孔径例如直径 50 微米以上甚至 100 多微米的微孔,如果用电镀填充满需要几个小时,不仅成本非常高而且良率也难以保证。
对于大孔径 TSV,瑞典有家 MEMS 公司却走出了另外一条“特色”技术路线。这家叫 Silex 的公司不走寻常路, 独立开发出了一项基于低阻硅的 Sil-Via 的 TSV 技术。Sil-Via 与电镀 TSV 有两大不同:首先,它用的硅基板材料本身就是低阻硅,其次,在制造过程中,Sil-Via 刻蚀的不是孔而是环槽,通过在环槽是填充绝缘材料的方式实现中心低阻硅圆柱作为导电介质。正是因为 Sil-Via 的巨大成功,Silex 也成为世界最大的 MEMS 代工厂。
2022 年 3 月 9 号,苹果公司推出的 M1 ULTRA 处理器,这款性能爆表的处理器中,多个 CPU 使用带 TSV 的 Silicon interposer 进行集成的。如今,无论是 AI/AR/VR 中用到的传感器,图像传感器,堆叠存储芯片以及高性能处理器,都越来越离不开 TSV。
TSV, 这项并不为人熟知的技术,正在硬件的底层深深的影响着人类的生产生活方式。
附;全球TSV重量级企业
日本东芝、韩国SK海力士、瑞士意法半导体、瑞士Silex公司、美国英特尔、美国AMD、美国应用材料公司。
国内;大港股份,赛微电子、晶方科技、通富微电、华天科技,长电科技等



- @啊哈哈:硅通孔技术(TSV)是HBM核心工艺,成本占比接近30%,是HBM封装成本中占比最高的部分,利用该技术才可以实现存储芯片3D堆叠等方面。
大港股份参股公司苏州科阳主要从事TSV晶圆级封装业务。 S大港股份(sz002077)S00打赏回复投诉 


 谢谢分享,TVS是核心重点
谢谢分享,TVS是核心重点
硅通孔技术(TSV)是HBM核心工艺,成本占比接近30%,是HBM封装成本中占比最高的部分,利用该技术才可以实现存储芯片3D堆叠等方面。
大港股份参股公司苏州科阳主要从事TSV晶圆级封装业务。00打赏回复投诉
- 1







